【學(xué)以精工】北理工優(yōu)秀專利成果:光電學(xué)院基于Abbe矢量成像模型的相移掩模優(yōu)化方法
發(fā)布日期:2013-07-16
閱讀次數(shù):供稿:北理工專利中心 編輯:黨委宣傳部
編制按:為了進(jìn)一步加強(qiáng)學(xué)校學(xué)術(shù)文化,、創(chuàng)新文化和人才文化建設(shè),,黨委宣傳部經(jīng)過認(rèn)真籌劃,圍繞我校重點(diǎn)科研學(xué)術(shù)進(jìn)展,,開辟《學(xué)以精工》科研學(xué)術(shù)新聞報(bào)道專欄,,旨在針對(duì)我校科研學(xué)術(shù)工作中取得的新成績,、新進(jìn)展進(jìn)行重點(diǎn)報(bào)道,,用通俗易懂的新聞報(bào)道,向校內(nèi)外展示北京理工大學(xué)的深厚科研實(shí)力和濃厚的學(xué)術(shù)氛圍,。本欄目得到了圖書館戰(zhàn)略情報(bào)研究部和學(xué)校專利中心(北京理工緯鉑知識(shí)產(chǎn)權(quán)代理有限公司)的支持,。歡迎全校單位和師生踴躍提供線索或投稿([email protected]),宣傳部將第一時(shí)間安排重點(diǎn)報(bào)道,。
光刻技術(shù)是大規(guī)模集成電路制造的關(guān)鍵技術(shù),,它是通過縮小投影成像技術(shù)將集成電路母版(mask)上的圖形轉(zhuǎn)移到光刻膠上,然后,,通過刻蝕技術(shù)等多道工藝,,實(shí)現(xiàn)集成電路的制備。提高光刻成像分辨率和圖形保真度是提高集成電路芯片集成度,、成品率及可靠性的關(guān)鍵技術(shù),。目前,采納離軸偏振照明,、浸沒式光刻(成像系統(tǒng)數(shù)值孔徑 NA>1)和相移掩模(phase-shifting mask PSM)等分辨率增強(qiáng)技術(shù),,可實(shí)現(xiàn)45nm及以下技術(shù)節(jié)點(diǎn)的芯片制造,助推信息產(chǎn)業(yè)的發(fā)展 ,。此時(shí),,需要采用矢量光刻成像理論和模型。
光電學(xué)院長江學(xué)者特聘教授李艷秋帶領(lǐng)課題組瞄準(zhǔn)國際前沿和國家重大科技戰(zhàn)略需求,,長期致力于193nm浸沒式和下一代極紫外光刻系統(tǒng)光學(xué)設(shè)計(jì),、光刻仿真和曝光系統(tǒng)偏振及像差檢測(cè)等方面的前沿研究,獲得了多項(xiàng)國際先進(jìn)成果,。特別是在光刻分辨率增強(qiáng)技術(shù)領(lǐng)域,,建立了嚴(yán)格的矢量成像理論和模型,課題組利用此模型研究了多項(xiàng)分辨率增強(qiáng)技術(shù),,申請(qǐng)了多項(xiàng)發(fā)明專利,。近年來,,利用此模型提出了一種基于Abbe矢量成像模型的相移掩模優(yōu)化方法,該方法采用該課題組自主研發(fā)的矢量模型對(duì)相移掩模進(jìn)行優(yōu)化,,即適用于具有高NA的浸沒式光刻系統(tǒng),,也適用于低NA的干式光刻系統(tǒng)。
該技術(shù)方案的核心在于課題組自主研發(fā)的Abbe矢量成像模型,,以及優(yōu)化掩模目標(biāo)函數(shù)的構(gòu)建,,不斷地重復(fù)迭代優(yōu)化掩模,通過目標(biāo)函數(shù)衡量掩模優(yōu)化的程度,,當(dāng)目標(biāo)函數(shù)滿足收斂條件時(shí),,掩模優(yōu)化完畢,成像效果最佳,。
下面三圖分別為未優(yōu)化掩模,、采用標(biāo)量成像模型優(yōu)化后的相移掩模、采用該課題組自主研發(fā)的Abbe矢量成像模型優(yōu)化后的相移掩模,,以及它們對(duì)應(yīng)的光刻膠中成像,。
光刻技術(shù)是大規(guī)模集成電路制造的關(guān)鍵技術(shù),,它是通過縮小投影成像技術(shù)將集成電路母版(mask)上的圖形轉(zhuǎn)移到光刻膠上,然后,,通過刻蝕技術(shù)等多道工藝,,實(shí)現(xiàn)集成電路的制備。提高光刻成像分辨率和圖形保真度是提高集成電路芯片集成度,、成品率及可靠性的關(guān)鍵技術(shù),。目前,采納離軸偏振照明,、浸沒式光刻(成像系統(tǒng)數(shù)值孔徑 NA>1)和相移掩模(phase-shifting mask PSM)等分辨率增強(qiáng)技術(shù),,可實(shí)現(xiàn)45nm及以下技術(shù)節(jié)點(diǎn)的芯片制造,助推信息產(chǎn)業(yè)的發(fā)展 ,。此時(shí),,需要采用矢量光刻成像理論和模型。
光電學(xué)院長江學(xué)者特聘教授李艷秋帶領(lǐng)課題組瞄準(zhǔn)國際前沿和國家重大科技戰(zhàn)略需求,,長期致力于193nm浸沒式和下一代極紫外光刻系統(tǒng)光學(xué)設(shè)計(jì),、光刻仿真和曝光系統(tǒng)偏振及像差檢測(cè)等方面的前沿研究,獲得了多項(xiàng)國際先進(jìn)成果,。特別是在光刻分辨率增強(qiáng)技術(shù)領(lǐng)域,,建立了嚴(yán)格的矢量成像理論和模型,課題組利用此模型研究了多項(xiàng)分辨率增強(qiáng)技術(shù),,申請(qǐng)了多項(xiàng)發(fā)明專利,。近年來,,利用此模型提出了一種基于Abbe矢量成像模型的相移掩模優(yōu)化方法,該方法采用該課題組自主研發(fā)的矢量模型對(duì)相移掩模進(jìn)行優(yōu)化,,即適用于具有高NA的浸沒式光刻系統(tǒng),,也適用于低NA的干式光刻系統(tǒng)。
該技術(shù)方案的核心在于課題組自主研發(fā)的Abbe矢量成像模型,,以及優(yōu)化掩模目標(biāo)函數(shù)的構(gòu)建,,不斷地重復(fù)迭代優(yōu)化掩模,通過目標(biāo)函數(shù)衡量掩模優(yōu)化的程度,,當(dāng)目標(biāo)函數(shù)滿足收斂條件時(shí),,掩模優(yōu)化完畢,成像效果最佳,。
下面三圖分別為未優(yōu)化掩模,、采用標(biāo)量成像模型優(yōu)化后的相移掩模、采用該課題組自主研發(fā)的Abbe矢量成像模型優(yōu)化后的相移掩模,,以及它們對(duì)應(yīng)的光刻膠中成像,。
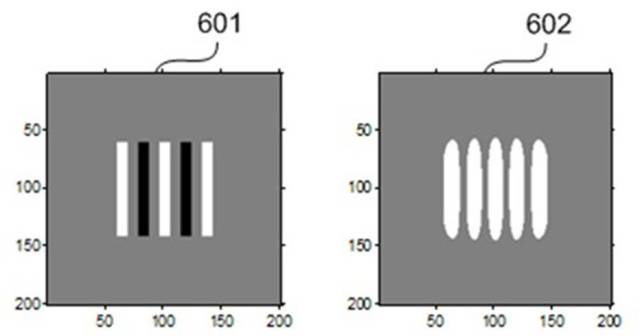
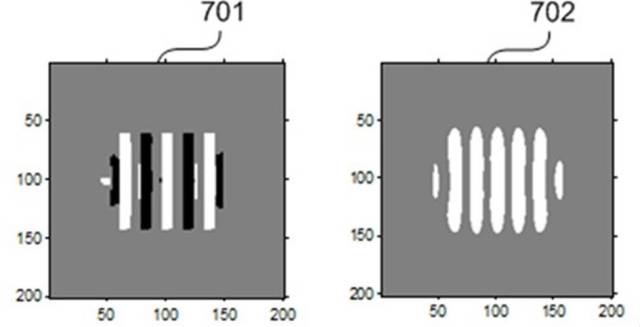

對(duì)比發(fā)現(xiàn),采用該發(fā)明方法的成像效果最佳,,其對(duì)應(yīng)的成像參數(shù)為,,成像誤差為324,CD誤差為0,。該項(xiàng)技術(shù)有利于進(jìn)一步提高光刻工藝水平,,為挖掘光刻設(shè)備成像分辨率潛力提供仿真依據(jù)和技術(shù)支撐,為提高芯片成品率提供可能途徑,,從而推動(dòng)集成電路制造行業(yè)的發(fā)展,。
北京理工大學(xué)光電學(xué)院長期以來十分重視對(duì)科研成果的知識(shí)產(chǎn)權(quán)保護(hù)。該項(xiàng)專利于去年通過北京理工大學(xué)專利中心(北京理工緯鉑知識(shí)產(chǎn)權(quán)代理有限公司)申請(qǐng)國家發(fā)明專利,,此項(xiàng)專利技術(shù)是我校近年來眾多優(yōu)秀科研專利成果之一,。在今后的專題新聞中,專利中心和宣傳部將會(huì)陸續(xù)選取各領(lǐng)域優(yōu)秀專利成果進(jìn)行重點(diǎn)報(bào)道,。
北京理工大學(xué)光電學(xué)院長期以來十分重視對(duì)科研成果的知識(shí)產(chǎn)權(quán)保護(hù)。該項(xiàng)專利于去年通過北京理工大學(xué)專利中心(北京理工緯鉑知識(shí)產(chǎn)權(quán)代理有限公司)申請(qǐng)國家發(fā)明專利,,此項(xiàng)專利技術(shù)是我校近年來眾多優(yōu)秀科研專利成果之一,。在今后的專題新聞中,專利中心和宣傳部將會(huì)陸續(xù)選取各領(lǐng)域優(yōu)秀專利成果進(jìn)行重點(diǎn)報(bào)道,。
附件:

(審核:專利中心)
分享到:
